


引言
随着下一代电子、光子和机械设备技术接近原子尺度,开发原子级精确的制造方法非常重要。其中,蚀刻停止对纳米电子和纳米机械设备的垂直集成起到了至关重要的作用,它是通过分层具有截然不同蚀刻特性的材料创建的,并嵌入到结构中,允许图案化特征尺寸、访问掩埋层或底切以创建悬浮结构。
英思特通过使用石墨烯作为不可渗透的蚀刻掩模和蚀刻停止,来制造纳米结构和以单个原子层的精度访问掩埋界面的方法。这些我们称之为GES(石墨烯蚀刻停止)的技术代表了一种直接的方法,它可以选择性地暴露和接触二维异质结构中嵌入的石墨烯层。 此方法利用了XeF2的高化学选择性,XeF2是一种气相强氟化剂,通常用作微机电系统(MEMS)行业中硅的各向同性蚀刻剂。
实验与讨论
为了检查GES(石墨烯蚀刻停止)的选择性和分辨率限制,英思特使用扫描透射电子显微镜 (STEM) 获得了蚀刻异质结构的横截面图像,如图1所示。重要的是,FG下的hBN(六方氮化硼)层未显示蚀刻,表明它们不受XeF2的影响。
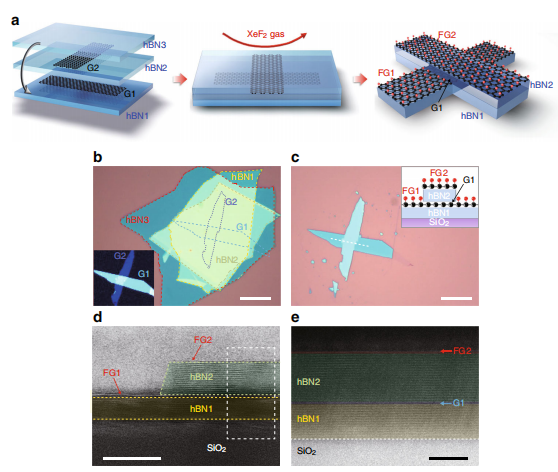
图1:异质结构的选择性蚀刻
此外,石墨烯掩埋层 (G1) 不受蚀刻工艺的影响,并且在堆叠的石墨烯和hBN(六方氮化硼)层之间存在原子级清晰且干净的界面(图2)。这些结果表明,FG通过化学改性过程保持了石墨烯的不可渗透性。在蚀刻掩模的边缘,下面的hBN(六方氮化硼)具有亚纳米斜率。这些图像表明,GES(石墨烯蚀刻停止)是一种自停蚀刻工艺,可实现平面外的原子精度和纳米级特征尺寸,而无需精确控制时间或条件。

图2:氟化石墨烯的拉曼和电导测量图
GES的自我约束性质意味着它是可扩展的且是原子精确的。英思特通过将GES应用于大面积异质结构阵列,从而展示了这种可扩展性。我们将大面积石墨烯图案化为用于图案化大面积WS2的蚀刻掩模,两者均通过化学气相沉积(CVD)生长。我们重复这种将预图案化石墨烯掩模与选择性蚀刻相结合的过程,以在晶圆级图案上可扩展地实现层状FG、石墨烯和其他材料的任意复杂异质结构,这是传统图案化和蚀刻技术无法实现的。
结论
英思特研究表明,GES能够实现基于2D材料的3D集成电子和机械设备的先进制造。这种技术的可扩展性将适用于从连续的大面积异质结构图案化的设备阵列,此过程的自我抑制性质意味着不需要精度来实现设备的均匀性,这在原子级精确的电子产品中是一个巨大的好处。
主要从事,,,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。