


引言
由于电子器件的不断小型化,原子层沉积(ALD)和原子层蚀刻(ALE)等原子层工艺对于半导体制造来说越来越重要。原子层蚀刻与ALD相反,是一种可以通过自限表面反应的原子层控制精确去除材料的技术。因此,ALE被认为是在原子尺度上实现低工艺可变性的最有前途的技术之一。目前ALE工艺都是基于卤化反应来修饰表面,然后用高能离子或惰性气体原子轰击来解吸卤素化合物,从而去除材料的。
实验与讨论
实验是在FHR-300-ALD反应器中进行的,该反应器同时允许ALD和ALE过程。模型层包括Si衬底、1.6nm天然二氧化硅的固定层和氧化铝膜。用于SE拟合的氧化铝光学模型为柯西模型。根据50个ALD循环后记录的原位光谱,确定了柯西模型的拟合参数。不同工艺温度下的光学性质分别不同,应用适当的通过光学层叠加模型,将每个椭偏光谱转化为氧化铝光学层厚度。
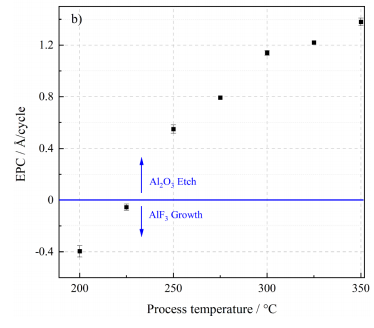
图1:不同工艺温度下的蚀刻速率
在工艺温度为225℃时,氧化铝蚀刻速率保持在零附近(−0.05A/cycle)。在225℃以下,材料被沉积;因此,EPC在图1中表示为负值。英思特以TMA和HF为反应物,在200℃下沉积的材料通过真空XPS测量进行了详细的检测。图2所示的成分证实了在较低的工艺温度下,与TMA和HF的连续表面反应导致氟化铝原子层沉积(ALD)。结果发现,F/Al的比值为3。

图2:在200°C下沉积的氟化铝ALD薄膜的组成
对于ALE循环的每个脉冲,英思特通过监测薄膜厚度随曝光时间的变化来确定TMA和HF反应的自限制行为。在恒定的工艺条件下,我们可以通过改变一个脉冲时间来检测EPC。对于每种组合,单个氧化铝膜经过50个氧化铝ALD循环生长。随后,在切换到不同的ALE脉冲时间之前,分别进行了30个周期的氧化铝ALE检测。计算了不同反应物暴露和净化脉冲时间下的EPC值。这种方法允许测试许多参数变化,从而实现快速和广泛的过程开发。
结论
英思特采用原位实时光谱椭偏法和准原位x射线光电子测量方法,探讨了以三甲基铝和氟化氢为反应物的氧化铝原子层蚀刻的顺序、自限性热反应。三甲基铝和氟化氢的顺序热反应以原子级精度线性蚀刻氧化铝。原位光谱椭偏分析证实了表面反应相对于反应物暴露的自限制行为。研究结果表面,配体交换反应在TMA暴露过程中仅去除部分氟化表层。在每个周期完成后,都可以检测到有界的氟原子。原位光谱椭偏法和准原位x射线光电子光谱测量法,非常适合于发展原子层过程和研究薄膜沉积或蚀刻。
主要从事,,,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。