


切割是一种简单而快速的方法,可以用于制备硅和其他半导体材料的样品;然而,尽管是单晶材料,但是蓝宝石的切割效果并不好。
现有的方法一般包括锯切和劈开,但由于断裂会向不需要的方向传播,并且在此过程中会损失材料,因此可能会导致产量不足。低温冷却和激光划线可以最大限度地减少不需要的断裂、碎裂、分层和材料损失的方法。然而,这些方法既昂贵又耗时,并且会带来其他不良问题,例如边缘质量差和温度变化引起的热损坏。
切割样品需要两个步骤:
薄弱点是在样品上形成的“缺陷”。它将是切割的起点。如果不首先通过金刚石划线器或压头制作薄弱点,则无法将基板分成两个独立的部分。
样品边缘的薄弱点(图1)很重要,因为切割是从薄弱点传播的,它决定了通过衬底晶面切割的质量和精度。如果薄弱点的角度较深或较宽且不直,则会导致断裂(甚至是微断裂),并且对切割面的质量和精度都会产生负面影响。
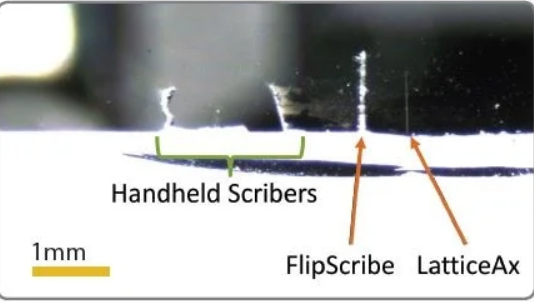
图1:金刚石划线器 FlipScribe 和 LatticeAx 造成的薄弱点。
切割是制备切割样品的第二步。通过在薄弱点上产生压力来发生切割。然后,裂解开始并传播到整个样本。如图2所示,如果样品是结晶的,则最佳弱点很短,因为它会在晶面后引发劈裂,随后的横截面将具有镜面光洁度。
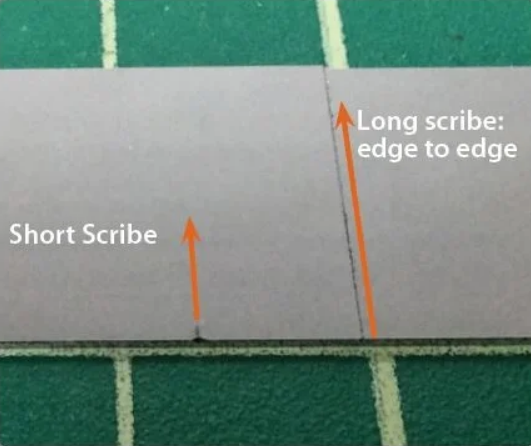
图2:短划线用于结晶材料,长划线用于非晶材料或与晶面相反的方向切割
如果样品是无定形的,样品将在没有晶面的情况下断裂,解理将在薄弱点的方向上扩展并且它可能不是直的,除非在所需解理线的整个距离上进行长划线,如图2所示。随后的横截面不会有镜面光洁度。当解理线必须与晶面相反时,这种“长划线”方法也可用于晶体材料。
我们需要注意的是,由于解理与晶面相反,所以边缘比较粗糙。可以通过用手指、钳子或别针将样品分成两块来进行切割。
主要从事,,,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。