


引言
英思特半导体提出了一种先进的湿式化学一步清洗工艺,它省略了盐酸/过氧化氢/水混合物步骤在RCA中。开发了一种新的一步清洗预浇口氧化物清洗溶液,以取代传统的RCA两步清洗配方,使用氨/过氧化氢或SC-1和HPM或SC-2步骤四甲基氢氧化铵~ TMAH被加入到RCA SC-1清洗溶液中,以提高清洗效率。从实验结果来看,采用该一步清洗溶液可以显著去除裸硅片表面的颗粒和金属污染。研究了各种清洗配方的有效性及其与硅表面的相互作用机理。【设备】【设备】【】【晶圆清洗设备制造】
实验与讨论
近年来,为了满足制备超薄氧化物的严格要求,人们提出了对传统的超薄氧化物两步清洗技术的许多改进。在这些研究中,已经提出了减少清洗步骤过程成本和周期时间的概念。【晶圆清洗设备制造厂家】【rca清洗设备】【马兰戈尼干燥设备】
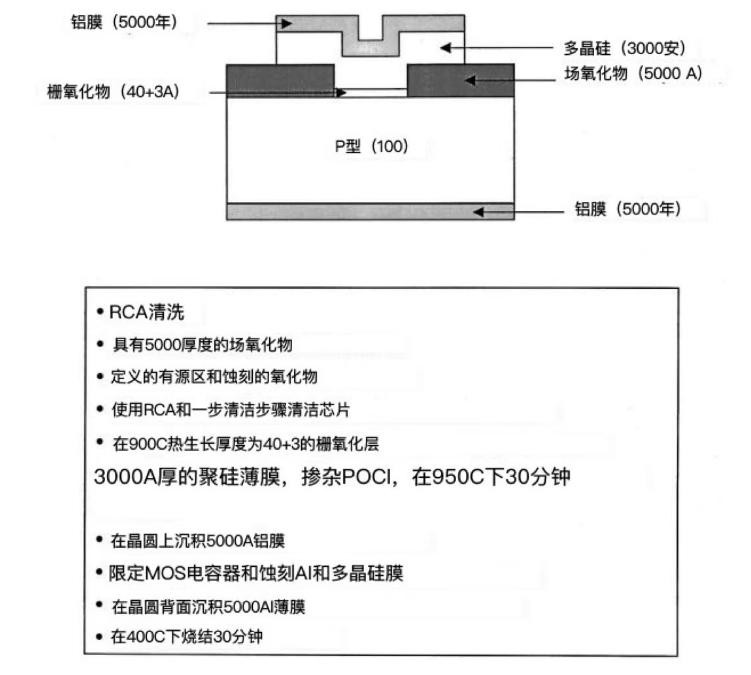
图1:电容器的电容器结构和制造步骤
图1描述了电容器的制造过程和清洗过程。金属氧化物半导体电容器是在一个4英寸上制造的。所有的晶圆首先用标准的RCA两步清洗方法进行清洗。A 5000 A场氧化物在1050°C下在热生气体中热生长1小时作为隔离层。用光刻技术和蚀刻技术确定了活性区域。【兆声清洗设备】【湿法刻蚀设备】【晶圆清洗设备】
用光谱椭偏振法测定了氧化物的厚度。氧化后,在低压化学气相沉积,然后在900°C下掺杂三氯氧磷30 min,其电阻率为30-40 V /h。.用热涂膜机在晶片上沉积了一个5000 A铝薄膜。用光刻法确定了MOS电容的栅极,然后用湿蚀刻法蚀刻铝薄膜和聚硅薄膜。晶圆片的背面也是用5000 A铝膜沉积。最后,将所有样品置于n2环境下,在400°C下烧结30 min,形成良好的欧姆接触。【KOH腐殖清洗机】【全自动晶圆清洗机】【RCA清洁设备】
RCA方法具有最光滑的表面,图2显示了这四种清洁配方中最粗糙的硅表面。除了粗糙度外,显然也比其他溶液具有最快的氧化物蚀刻速率。该图还表明,含有羟化四甲铵(TMAH)和乙二胺四乙酸(EDTA)的清洗溶液具有明显较高的表面粗糙度。这种趋势可以归因于两个原因。首先,解决方案更基本,更基本的条件会导致较高的氧化物蚀刻率和表面粗糙度。第二,乙二胺四乙酸阴离子可以出现在图2的第二层。【英思特】【英思特半导体】【湿法制程】【】【晶圆清洁设备】【】

图2:疏水颗粒和亲水颗粒在硅表面的吸附。
结论
如果通过引入一步清洗溶液,其中添加TMAH或EDTA,从而省略SC-2清洗步骤,则可以简化半导体制造过程中的传统湿式清洗过程。英思特研究了TMAH的四甲基铵阳离子对超薄氧化物膜的表面粗糙度、蚀刻率和电学特性的影响。【全自动晶圆清洗机】【RCA清洁设备】【马来西亚戈尼干炎装备】【兆声清洗】【湿法刻蚀】
这一发现可以用TMAH的四甲基铵离子的表面吸附和双层行为来解释。研究了硅表面粗糙度、颗粒和金属对电容器泄漏电流、电击穿场和电荷击穿等电性能的影响,以评价晶片表面的清洁度。用TMAH清洗SC-1是去除颗粒的有效方法,但仍有发现金属污染。将EDTA加入到SC-1溶液中,显示了防止金属污染的有效性能。【湿法制程设备】【湿法设备制造厂家】【rca清洗设备】【马兰戈尼干燥设备】【兆声清洗设备】
主要从事湿法制程设备,晶圆清洗设备,RCA清洗机,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。