


引言
氢氧化钾(氢氧化钾)是一种用于各向异性湿蚀刻技术的碱氢氧化物,是微加工硅片较常用的硅蚀刻化学方法之一。使用氢氧化钾工艺是因为其在制造过程中的可重复性和均匀性,同时保持了较低的生产成本。异丙醇(IPA)经常被添加到溶液中,以改变从壁到壁壁的选择性,并提高表面光滑度。
实验与讨论
氧化物和氮化物在氢氧化钾中缓慢腐蚀,可以作为氢氧化钾蚀刻浴中短时间的蚀刻掩模。对于较长的时间,氮化物是一个更好的面具,因为它在氢氧化钾中蚀刻速度要慢得多。另一种替代方法(对许多其他功能也很有用)是在晶圆片上掺杂硼。它还将降低蚀刻速率,实际上阻止了富硼硅的蚀刻。【rca清洗设备】【马兰戈尼干燥设备】【设备】【设备】【】
在80ºC时,侵蚀速率随着氢氧化钾浓度的增加而增加,当浓度达到18wt%,当氢氧化钾浓度增加到18wt%以上时,蚀刻率降低。在蚀刻过程中发生的化学反应是这种变化的结果。这将在后面进行更深入的讨论。使用氢氧化钾蚀刻有几个缺点。较大的问题是在蚀刻过程中产生的h2气泡。这些h2气泡作为一个假掩膜。这增加了粗糙度,并可能破坏微观结构。与氢氧化钾蚀刻有关的另一个问题是氢氧化钾中含有碱离子。【全自动晶圆清洗机】【RCA清洁设备】【英思特】【英思特半导体】
使用KOH+IPA溶液形成一致的垂直侧壁已被证明是不可靠的。英思特半导体使用足够高的氢氧化钾浓度和温度,实现了可靠的垂直侧壁。我们使用了50%的氢氧化钾浓度和80ºC的温度进行了可靠的选择。这个实验的目的是创造一个房子形状的结构(如图1)。倾斜的屋顶是由平面和垂直的墙制成的。【湿法制程】【】【晶圆清洁设备】【】【全自动晶圆清洗机】
由于屋顶只有一个可用的面具图案,所以屋顶必须做得更小。于是导致发现了一种新的角补偿技术,使用无掩模蚀刻技术和高氢氧化钾浓度下的KOH+IPA。在使用无掩模蚀刻的氢氧化钾浴中进行了15分钟后,由于在面具下的高阶平面造成的屋顶圆角消失了,这一步确实增加了表面纹理。【RCA清洁设备】【兆声清洗】【湿法刻蚀】【湿法制程设备】【湿法设备制造厂家】

图1:微房建设
KOH+IPA中低浓度氢氧化钾导致倾斜的45º{110}壁粗糙,形成平行凹槽。四面体金字塔也覆盖了晶圆表面。在使用接近35%的浓度时,可以观察到更光滑的表面。{100}用低浓度的纯氢氧化钾产生的壁面表面非常粗糙。浓度越高,表面光滑度越好,但仍不如添加IPA产生的浓度好。使用50%的氢氧化钾,KOH+IPA溶液产生垂直壁。图2比较了50%氢氧化钾和KOH+IPA蚀刻特征的结果。【rca清洗设备】【兆声清洗设备】
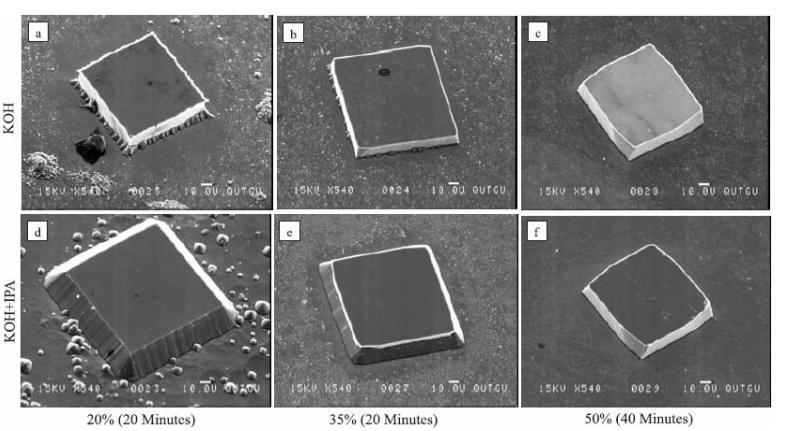
图2:腐蚀样品对比
结论
各向异性多步蚀刻结合了许多蚀刻过程与蚀刻剂、蚀刻条件和掩蔽的变化。英思特半导体使用氢氧化钾湿法蚀刻和两步法对{001}晶片进行了实验,对蚀刻结果进行了模拟,并与实际结果进行了比较,研究了两种两步加工方法。【晶圆清洗设备】【晶圆清洗设备厂家】
第一个涉及在使用相同的蚀刻剂的步骤之间反向设置掩模边缘的位置。这两个步骤的掩模边缘对齐相同,但使用<110>的<100>和氢氧化钾或KOH+IPA作为蚀刻剂进行测试。第二个过程在两步中使用了不同的蚀刻剂,但保持面具不变。第一步要么使用氢氧化钾,第二步要么使用KOH+IPA,反之亦然。【全自动晶圆清洗机】【兆声清洗】【湿法制程设备】
英思特提到的两个数字包括一个轮廓,其中两个侧壁左右结合,另一个使用不同的技术,留下中间的两个侧壁左右结合并蚀刻穿孔,指出,前者“可以用来环绕一个矩形膜,减少边缘的机械应力。”它还指出,后者“可以形成弯曲和扭转的弹簧”。
主要从事湿法制程设备,晶圆清洗设备,RCA清洗机,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。