


引言
在复杂的MEMS惯性传感器的制造中,有许多情况下,金属化不能通过通常的模式方法完成。在这种情况下,有必要为传感器的最终金属化制造一个阴影掩模。使用深反应离子蚀刻(DRIE)在硅(Si)中制造阴影掩模是复杂的,因为这需要使用支撑晶片来防止氦冷却剂泄漏。氢氧化钾(KOH)和四甲基氢氧化铵(TMAH)是MEMS中湿式体微加工最常用的湿式各向异性蚀刻剂。【设备】【设备】【】【晶圆清洗设备制造】【晶圆清洗设备制造厂家】
与TMAH相比,KOH在Si{100}/Si{110}和Si{111}之间具有更高的蚀刻速率和更高的蚀刻各向异性。英思特采用15%NH2OH加20 wt%KOH,首先研究了蚀刻特性,然后在较低温度下老化效应引起的变化。本文研究了不同浓度的NH2OH对使用20wt% KOH和5wt% TMAH的Si{100}蚀刻特性的影响,发现15% NH2OH是20 wt% KOH中获得改进蚀刻特性的最佳浓度。【rca清洗设备】【马兰戈尼干燥设备】【兆声清洗设备】【湿法刻蚀设备】【晶圆清洗设备】
实验与讨论
本文对Si{100}和{110}进行了蚀刻实验,以优化蚀刻条件,从而提高了Si的蚀刻速率和Si与二氧化硅之间的蚀刻选择性。使用丙酮去除光刻胶,然后在去离子(DI)水中冲洗。晶圆被切成2×2 cm2大小的小晶片。在去离子水中加入所需重量的氢氧化钾球团,制备20 wt%的KOH溶液。实验分别在50、55和60℃的不同温度下进行。【KOH腐殖清洗机】【全自动晶圆清洗机】【RCA清洁设备】【英思特】【英思特半导体】【半导体】
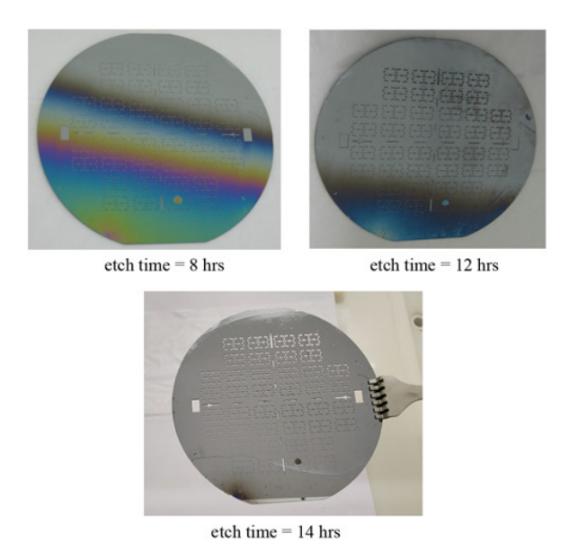
图1:使用纯20 wt%KOH在Si{100}晶片中制造通孔晶片的不同阶段
最初,通孔制造在55℃中使用纯20 wt%氢氧化钾溶液,图1显示了使用4英寸20 wt%KOH溶液三个不同阶段蚀刻{100}晶片的图像,可以看出,二氧化硅开始从一侧被蚀刻出来,并在通过孔形成时被完全去除。【湿法制程】【】【晶圆清洁设备】【】【KOH腐殖清洗机】【全自动晶圆清洗机】【RCA清洁设备】
在晶圆片上通过孔实现蚀刻的总时间为14小时,这证实了在较低的温度下,我们可以有效地使用15%的NH2OH添加的20 wt%的KOH溶液。作为蚀刻剂成分的温度为55℃,其蚀刻温度表现出相当高的硅蚀刻,并且提高了硅和氧化物之间的蚀刻选择性。图2显示了4英寸Si{100}晶片的图像。二氧化硅掩模在整个蚀刻过程后被保留。【马来西亚戈尼干炎装备】【兆声清洗】【湿法刻蚀】【湿法制程设备】【湿法设备制造厂家】【rca清洗设备】【马兰戈尼干燥设备】
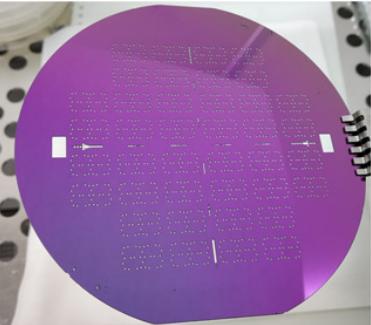
图2:使用15%羟胺+ 20 wt%氢氧化钾在Si{100}晶片上制造的通孔
结论
英思特在50-60℃的低温下,详细研究了{100}和{110}在20wt%氢氧化钾和20 wt%氢氧化钾溶液中的蚀刻特性。在5天内,研究了添加NH2OH的氢氧化钾溶液对蚀刻特性的老化影响。结果表明,在55℃条件下,添加15%NH2OH的20wt%氢氧化钾是利用热生长的氧化物层作为掩膜在Si{100}晶片上形成一个孔的最佳条件。因此,这项工作可直接用于湿式微加工生产MEMS设备。【兆声清洗设备】【湿法刻蚀设备】【晶圆清洗设备】【晶圆清洗设备制造】【晶圆清洗设备制造厂家】
主要从事湿法制程设备,晶圆清洗设备,RCA清洗机,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。