


引言
正如著名的摩尔定律所描述的那样,半导体密度在近几十年取得了进展,今天仍在发展。这些半导体元件被组装在一个称为封装衬板的插入器上。封装基板允许这些组件安装在一个基础印刷电路板(PCB)使用廉价的焊接技术。当半导体尺寸减小时,封装衬底尺寸也会减小。【设备】【设备】【】【晶圆清洗设备制造】【晶圆清洗设备制造厂家】
相关的PCB特征尺寸也遵循相同的比例因子。半导体小型化带来了显著的经济和技术效益,半导体规模因子成为相关封装和PCB设计的主体。半加性工艺(SAP)最近已被开发用于精细特征的多氯联苯。然而,由于担心铜与基材的粘附,这主要是利用薄铜箔基材工艺。本文介绍了一种利用化学镀铜作为基体导体的新型SAP。【rca清洗设备】【英思特】【英思特半导体】【半导体】【湿法制程】【】
SAP工艺和基础铜
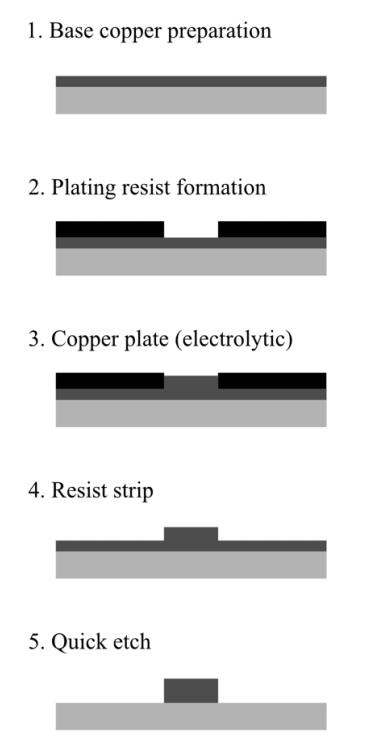
图1. SAP工艺流程
SAP基本上是使用北美PCB制造商通常使用的面板图案电镀方法的工艺概念。然而,与减法过程不同的是,SAP镀铜只选择性地应用于图案,导致更薄的铜被蚀刻掉。第一步是制备铜,使用铜箔和镀铜。第二步形成在基铜上有负图案的镀层。然后是第三步板上的电路铜。第四步是镀胶带,最后一步是快速蚀刻不必要的基铜。(图1)【】【】【KOH腐殖清洗机】【全自动晶圆清洗机】
SAP使用薄薄的铜基层进行电解电镀。与完全添加剂无化学电镀方法相比,这是一个优点。如表1所述,有实现实现薄基铜的各种方法。【马兰戈尼干燥设备】【马来西亚戈尼干炎装备】【湿法刻蚀设备】【晶圆清洗设备】【晶圆清洗设备制造厂家】
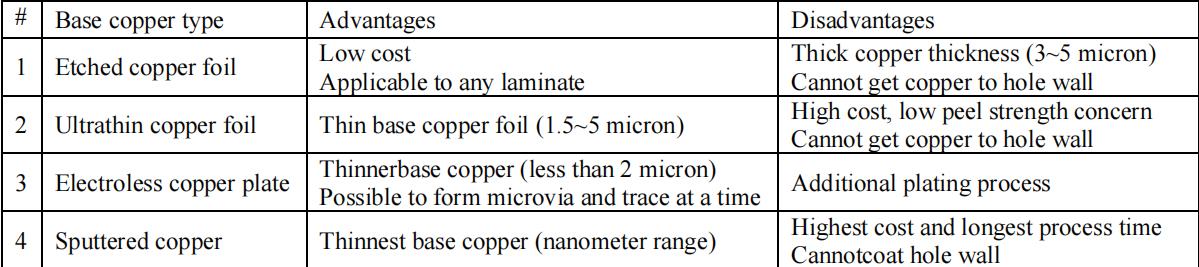
表1. SAP基铜类型及其优缺点
当前挑战的基础知识
化学铜板是一个很好的解决方案,超越铜箔方法更精细的间距设计与SAP,因为它可以使用内基导体。但是,传统的锡-钯胶体催化剂偶尔沉积在基底表面,颗粒之间的距离为10纳米或以上。此外,沉积的催化剂是锡钯合金,并且与纯钯催化剂颗粒相比,其催化活性点被还原。最初的铜原子沉积开始,零星而不连续地沉积,当沉积的铜积累足够多时,铜原子沉积最终排列并致密。(图2)【英思特】【英思特半导体】【江苏英思特半导体科技有限公司】【湿法制程】

图2.使用常规锡钯或离子钯催化剂的非化学铜沉积示意图
结论
利用羧酸钯开发了一种新型的催化剂油墨。这种油墨使用选定的有机溶剂,它提供了催化剂的高润湿性和渗透到衬底表面的任何特征,包括孔壁和盲孔的衬垫。涂覆的油墨通过热或化学减速剂固化。在衬底上以一层纳米级的厚度形成一种非常均匀的钯。这在性能和经济方面都提供了非常高效的催化剂。【晶圆清洗设备】【全自动晶圆清洗机】【晶圆清洁设备】【晶圆清洗设备制造】
在油墨上的化学过程提供了亚纳米范围的颗粒,它具有非常高的催化剂活性。当该LMI用于化学镀铜时,如0.5微米或更少的超薄铜可以给整个面板足够的导电均匀性,以运行电解铜镀铜。因此,当该超薄基铜用于SAP工艺时,PCB可以具有亚10微米的痕迹和空间等精细特性。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洗设备,RCA清洗机,KOH腐蚀清洗机、酸碱清洗设备、机、炉管清洗机等设备的设计、生产和维护,联系人缪经理,联系电话18012895988。