


功率器件,构成电力电子系统的核心,控制电流,硅基功率器件因其低成本和良好的电气性能而一直是主要选择。然而,电动汽车、高铁和快速充电等新兴应用更加依赖宽带隙材料(SiC和GaN),因为它们具有更高的工作电压和更快的开关能力。【兆生清洗设备】【设备】【】【晶圆清洗设备制造】
虽然SiC器件在2020年仅占整个功率器件市场的4%左右,但预测未来5-7年复合年增长率将超过30%。另一方面,硅基氮化镓器件与600-650V范围内的硅器件竞争,但市场规模要小得多(占总功率器件的1%)。预计这些设备在未来5年内还将大幅增长。【晶圆清洗设备制造厂家】【rca清洗设备】【】【兆生清洗设备】【湿法刻蚀设备】
SiC功率器件的蚀刻工艺
蚀刻碳化硅是一项特别具有挑战性的工艺,因为该材料的硬度接近金刚石。它还具有非常稳定的化学结构。这使得干法蚀刻比GaAs、AlGaAs 或InP等其他化合物层更困难,后者具有更多的化学蚀刻机制,需要传统的电感耦合等离子体(ICP)工艺模块。【晶圆清洗设备】【KOH腐殖清洗机】【】【RCA清洁设备】【英思特】【】
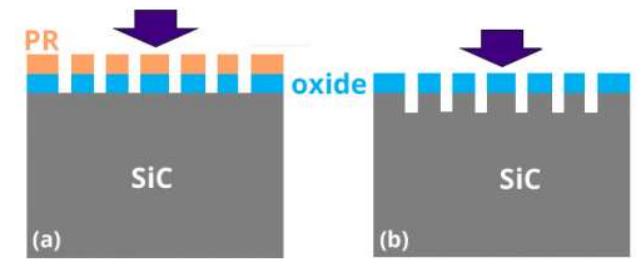
图1;示意图显示(a)硬掩模打开和(b)正面SiC沟槽蚀刻
氧化掩模打开
氧化硅用作硬掩模,可以承受蚀刻SiC 所需的侵蚀性蚀刻条件。掩模开口步骤的关键要求是高氧化物蚀刻速率以提高生产率,并具有用于后续SiC沟槽蚀刻的精确轮廓控制的垂直轮廓,以及底层SiC的最小损失。这需要使用OES(光学发射光谱)进行精确的终点检测并控制整个晶圆上的蚀刻均匀性。【半导体】【】【】
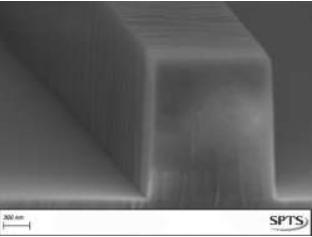
图2:氧化物掩模以0.45μm/min蚀刻
浅(正面)SiC沟槽蚀刻
与传统平面设计相比,功率器件通常采用垂直沟槽结构来降低导通电阻并提高封装密度。这些沟槽的深度通常为1-2μm,宽度为0.5-1.5μm。沟槽基底不需要微沟槽来确保栅极氧化物质量、多晶硅的无空隙填充以及防止导致击穿的高局部电场。对于在更高电压下运行的下一代器件,我们希望通过形成具有圆形底部的沟槽来完全避免沟槽中任何形式的拐角。在较宽/较浅的SiC沟槽中很难实现这种轮廓,但通过仔细控制蚀刻/钝化化学物质,侧壁上聚合物的堆积可以减少沟槽底角处的蚀刻,从而形成圆形。通过蚀刻后湿法清洁可以轻松去除聚合物钝化层。随着沟槽CD的减小和纵横比的增加,该方法变得更加容易。SiC 沟槽蚀刻的示例如图3所示。【】【晶圆清洁设备】【】【KOH腐殖清洗机】
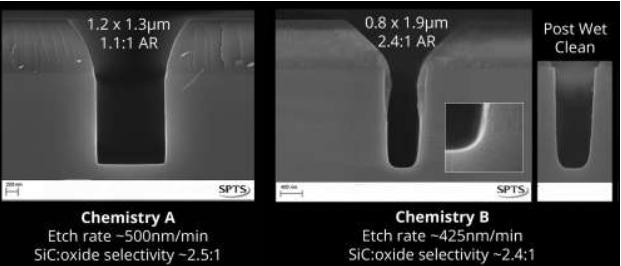
图3:浅正面SiC沟槽蚀刻的两个示例
为了确保生产中晶圆间的可重复性,这种浅沟槽工艺可以通过白光干涉测量来结束,但前提是蚀刻面积足够高。激光干涉测量法可用于任何沟槽开放区域,但需要将直径为25μm 的光斑放置在约350μm的目标特征内(当选择模式识别软件时,会减小到约250μm)。然后可以在目标特征的深度和真实沟槽的深度之间建立关联,以确保精确的晶圆到晶圆沟槽深度控制。【马来西亚戈尼干炎装备】【兆生清洗】【湿法刻蚀】【湿法制程设备】
硅基氮化镓功率器件的蚀刻工艺
硅基氮化镓功率器件可能需要多种不同的正面蚀刻工艺,具体取决于工艺路线和最终所需的结构。一般来说,这些是SiNx或外延GaN或AlGaN的浅蚀刻。这些需要可控的低蚀刻速率、低操作功率以最小化等离子体引起的损伤以及对底层的高选择性以最小化薄层的损失。【湿法制程设备】【湿法设备制造厂家】【rca清洗设备】【马兰戈尼干燥设备】
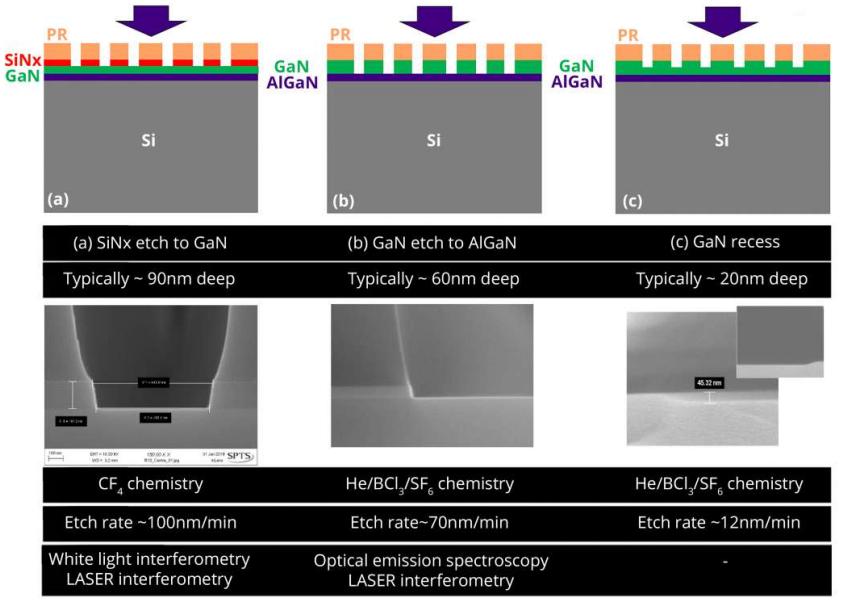
图4:硅基氮化镓功率器件三个关键正面蚀刻步骤的示意图
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护,联系人吴经理,联系电话18014374656(微信同号)