


引言

图一。(a)完全各向异性,( b)部分各向异性,以及(c)硅的各向同性蚀刻
定义
湿法蚀刻是一种材料去除工艺,使用液体化学品或蚀刻剂从晶片上去除材料。特定的图案由晶片上的掩模限定。不受掩模保护的材料被液态化学物质蚀刻掉。在先前的制造步骤中,使用光刻法在晶片上沉积和图案化这些掩模。(设备,设备,制造厂家)
在干法蚀刻中,等离子体或蚀刻气体去除衬底材料。发生的反应可以利用粒子束的高动能、化学反应或两者的结合来完成。(英思特,)
湿法蚀刻工艺涉及多个化学反应,这些化学反应消耗原始反应物并产生新的反应物。湿法蚀刻工艺可以通过三个基本步骤来描述。(1)液体蚀刻剂向待去除的结构扩散。(2)液体蚀刻剂和被蚀刻掉的材料之间的反应。通常会发生氧化还原反应。该反应需要材料的氧化,然后溶解氧化的材料。(3)反应中的副产物从反应表面扩散。
各向异性湿法蚀刻
液体蚀刻剂以不同的速率蚀刻晶体材料,这取决于哪个晶面暴露于蚀刻剂。取决于硅,蚀刻速率有很大的差异水晶平面。在诸如硅的材料中,这种效应可以允许非常高的各向异性。硅的一些各向异性湿法蚀刻剂是氢氧化钾(KOH)、乙二胺焦儿茶酚(EDP)或四甲基氢氧化铵(TMAH)。蚀刻a(100)硅晶片将导致如图2a所示的金字塔形蚀刻坑。蚀刻的壁将是平的和有角度的。与晶片表面的角度为54.7度。图2c-d描绘了基于KOH基湿法蚀刻产生的具有微米和纳米级尺寸的(110)取向二维硅壁的扫描电子显微照片。(兆声清洗设备,湿法刻蚀设备,晶圆清洗设备制造厂家,
各向同性湿法蚀刻
对于各向同性湿法蚀刻,氢氟酸、硝酸和醋酸(HNA)的混合物是较常见的硅蚀刻剂溶剂。每种蚀刻剂的浓度决定了蚀刻速率。二氧化硅或氮化硅通常被用作抗HNA的掩模材料。当反应发生时,材料以类似于向下蚀刻的速度横向移除。这种横向和向下的蚀刻过程甚至发生在干法蚀刻部分描述的各向同性干法蚀刻中。(晶圆清洗设备制造,晶圆清洗设备制造厂家,英思特)
即使存在掩模,湿法化学蚀刻通常也是各向同性的,因为液体蚀刻剂可以渗透到掩模下面(图2b)。如果方向性对于高分辨率图案转移非常重要,通常不使用湿法化学蚀刻。
物理干法蚀刻
物理干法蚀刻需要高能动能(离子、电子或光子)束来蚀刻掉衬底原子。当高能粒子将原子从衬底表面敲出时,材料在离开衬底后蒸发。没有化学反应发生,因此只有未被掩蔽的材料将被去除。


一个b

c d
图二。(100)取向硅表面的(a)各向异性和(b)各向同性蚀刻中的蚀刻轮廓示意图
化学干法蚀刻
化学干法蚀刻(也称为气相蚀刻)不使用液体化学品或蚀刻剂。这个过程包括蚀刻气体之间的化学反应,以侵蚀硅表面。
化学干法蚀刻工艺通常是各向同性的,并表现出高选择性。与各向同性蚀刻相比,各向异性干法蚀刻能够以更精细的分辨率和更高的纵横比进行蚀刻。(英思特,英思特半导体)
反应离子蚀刻
反应离子蚀刻(RIE)使用物理和化学机制来实现高水平的分辨率。该过程是工业和研究中较多样和较广泛使用的过程之一。因为该过程结合了物理和化学相互作用,所以该过程要快得多。电离产生的高能碰撞有助于将蚀刻剂分子分解成更具活性的物质。


图3。等离子体以高能量撞击硅晶片以敲掉表面上的硅原子


图4。活性离子与硅表面相互作用的过程
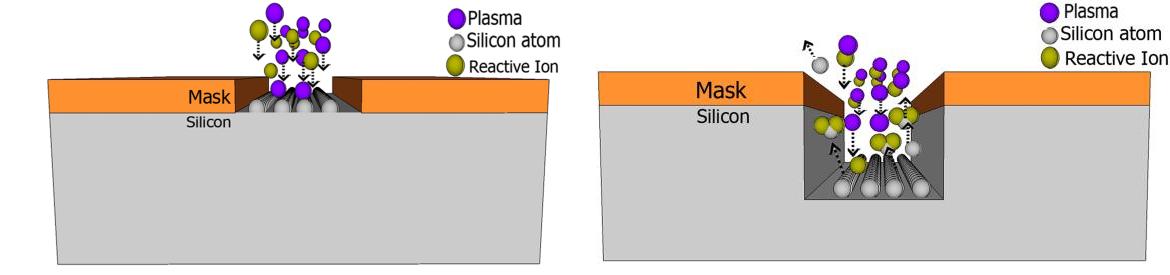
图5。RIE工艺。这个过程包括物理和化学反应来蚀刻掉硅。